隨著半導體前段製程的微縮面臨技術與成本的挑戰,為了繼續提升單位面積的電晶體數量,晶圓代工廠和封測廠正共同推動先進封裝技術的發展。
先進封裝就是將不同種類的晶片透過封裝、堆疊技術整合在一起,以提升晶片的性能、縮小尺寸、減少功耗。
今天就來談談其中一項技術-Hybrid Bonding(混合鍵合)。
Hybrid Bonding是什麼?
Hybrid Bonding是將晶片連接的技術,相較於封裝主流技術的Bump(凸塊)接合,Hybrid Bonding是透過金屬(如銅)和氧化物鍵合,最大優勢就是降低凸塊的間距並縮小接點間距,由此可以在相同的面積下提升連接密度,也就達到更快的傳輸速度並且降低能耗。
(資料來源:K&S)
Hybrid Bonding製作流程
Hybrid Bonding 主要步驟為:
-
晶圓準備(Wafer Preparation)
-
氧化物沉積(Oxide Deposition)
-
金屬層沉積(Metal Deposition)
-
對準與鍵合(Alignment and Bonding)
-
退火處理(Annealing)
-
檢測與測試(Inspection and Testing)
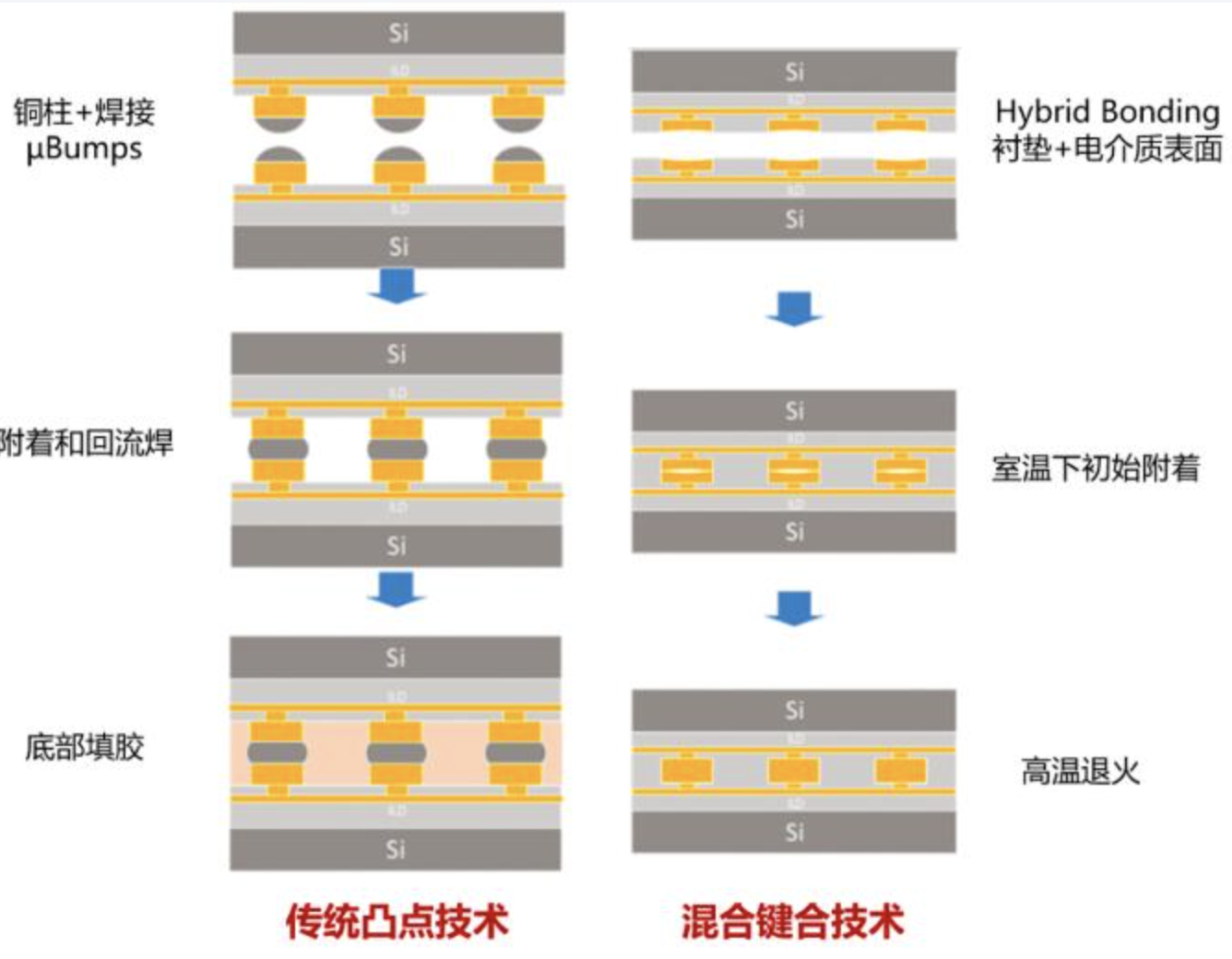
(資料來源:薩科微半導體)
Hybrid Bonding運用於3D先進封裝新技術-SoIC
在AI浪潮引爆之下,CoWoS產能需求激增,驅使台積電積極擴充CoWoS產能,除了CoWoS之外,台積電還有另一個3D先進封裝技術-SoIC(System-on-Integrated-Chips)。
SoIC(System-on-Integrated-Chips)是業界第一個高密度3D小晶片堆疊技術,用於十奈米及以下的先進製程進行晶圓級的鍵合技術。
而SoIC有兩種堆疊方案,分別為SoIC-P(Bumped)和 SoIC-X(Bumpless) 。
SoIC-P 是微凸塊堆疊解決方案,適用於行動應用等講求成本效益的應用。
另一種 SoIC-X是採Hybrid Bonding(混合鍵合),適合用於 HPC、AI 領域。
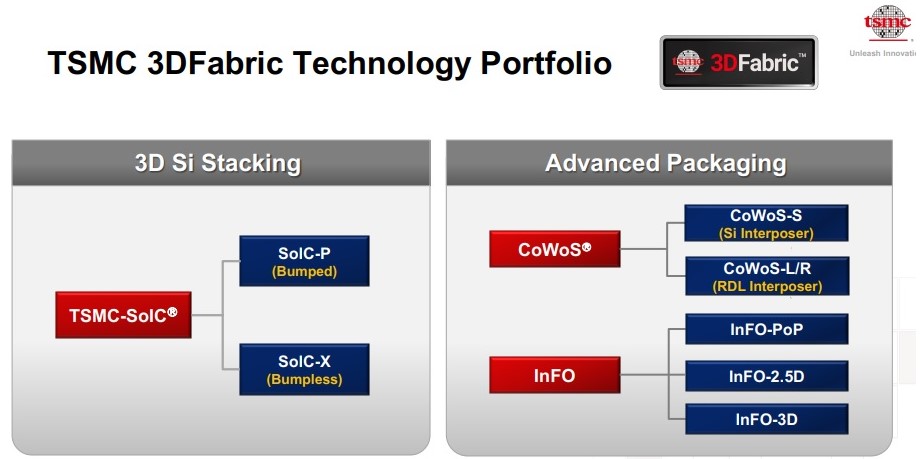
(資料來源:台積電)