晶圓級晶粒尺寸封裝Wafer-Level Chip-Scale Package (WLCSP)與傳統封裝的差別在於,傳統封裝是先將晶圓切成晶粒之後再包起來封裝。
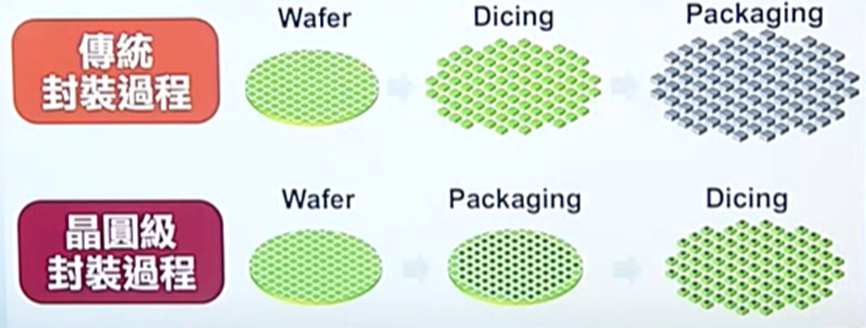
圖片來源:曲博科技
而晶圓級封裝則是運用化學製程的方式先封裝完後,再上金屬球才切開,這樣的封裝好處在於運用化學製程封裝,使整體體積能夠縮小,更能符合未來的趨勢。
其中晶圓級封裝又可分為扇出型(Fan-out)與扇入型(Fan-in),扇出與扇入的標準在於金屬球是否超越晶片面積而定義,如下圖。
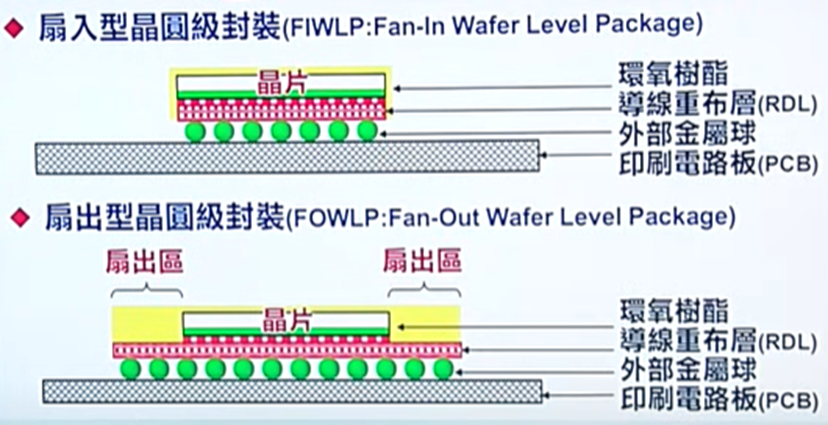
但扇出型往往造成晶片之間的空間過大,加上晶圓級是先封裝才切割,所以一片晶圓切割數量有限,容易造成成本上升。
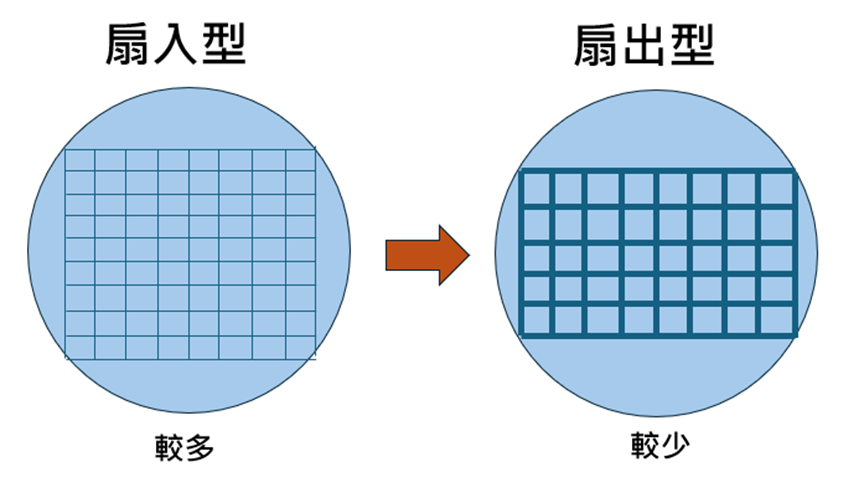
若粗線區域為扇出空間,隨扇出空間增加,一片晶圓所能切割的晶粒便越少,不符合成本下,於是衍生出FOPLP(面板扇出型封裝)
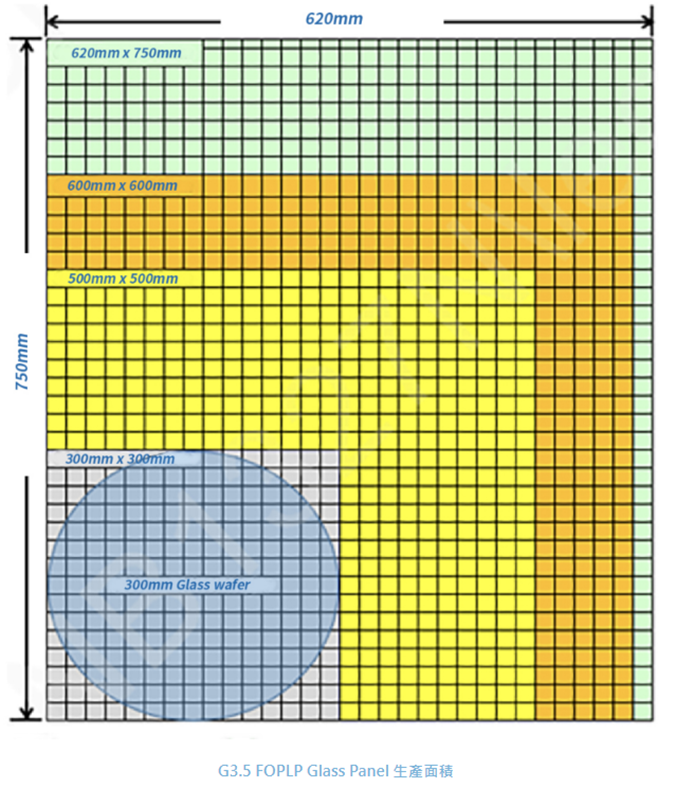
圖片來源:群創官網
我們可以發現面板級晶圓能夠裁切的晶粒將更多,面積是原本12吋晶圓的7倍,將有效減少成本浪費。
而面板級晶圓技術運用的材料為玻璃,主要優勢在於較不會因為過熱而翹曲,英特爾正密集研發當中,未來有望成為下一代pcb板材質之一。
面板扇出型封裝示意圖
透過面板級玻璃,用環氧樹脂將晶片背面固定完,再透過雷射除膠技術將玻璃卸下。
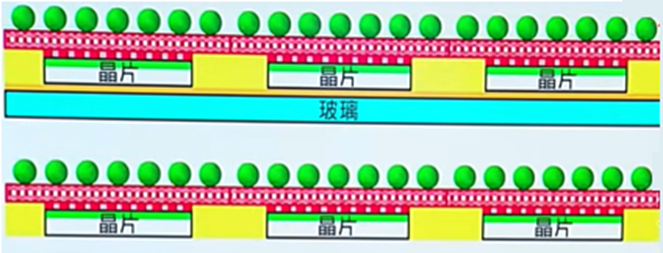
之後透過切割,右邊單片就稱為面板扇出型封裝FOPLP,左邊部分以兩個晶片為一組切割,稱為整合扇出型封裝,台積電將其命名為InFO
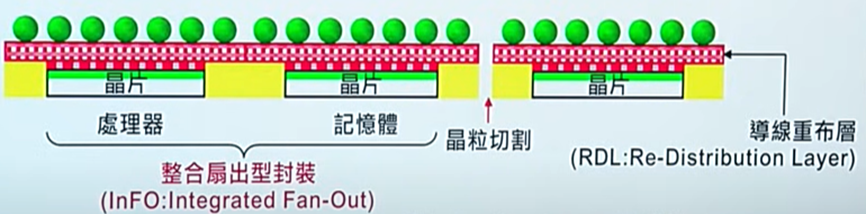
其中玻璃為微米級,可由台灣相關面板廠製作,而群創首度提出「Panel Semiconductor」面板半導體概念,能夠高度整合晶片的先進封裝技術,成為群創在跨界半導體產業發展的重要方向之一。
目前群創這項技術以活化現有G3.5產線, 以業界最大尺寸G3.5 FOPLP (620mm X 750mm) Glass Panel開發線寬介於 2μm ~10μm的中高階半導體封裝。
優點除了方型之高玻璃利用率,也可發揮「容納更多的 I/O 數」、「體積更小」、「效能更強大」、「節省電力消耗」等技術優勢。
長期群創有望轉型之下,另外我們從優分析小助理當中,可以看到群創近期利多如下

另外我們來看看五月份面板報價,目前還是以大尺吋面板漲幅較高。

群創(3481-TW)預估第二季大尺寸面板價格估季增 11-13%、平均售價則可望季增 4-6%;中小尺寸面板出貨則估季減 7-9%。
4 月營收方面為193億元,月減 4.3%、年增13.1%;累計前 4 月營收697.47 億元,年增11.4%,高於法人預估。

公司表示主要受惠三大運動賽事的到來、新品備貨潮以及中國 618 促銷、目前看到大尺寸、電視確實需求存在,並認為,第一季景氣是谷底、全年將逐季攀升。
所以未來面板廠是否有機會進軍半導體相關材料設備,並且享受更高本益比,長線上可以持續留意觀察FOPLP的成長力道,而短線上則可以留意奧運與歐洲盃等賽事的影響力。










